中科院:计算光刻技术取得重大进展
中科院:计算光刻技术取得重大进展
中国科学院官网刊文称,上海光机所在计算光刻技术研究方面取得重要进展。
近日,中科院上海光学精密机械研究所信息光学与光电技术实验室提出一种基于虚拟边(Virtual Edge)与双采样率像素化掩模图形(Mask pixelation with two-phase sampling)的快速光学邻近效应修正技术(Optical proximity correction, OPC)。仿真结果表明,该技术具有较高的修正效率。
光刻是极大规模集成电路制造的关键技术之一,光刻分辨率决定集成电路的特征尺寸。随着集成电路图形的特征尺寸不断减小,光刻系统的衍射受限属性导致明显的光学邻近效应,降低了光刻成像质量。
在光刻机软硬件不变的情况下,采用数学模型和软件算法对照明模式、掩模图形与工艺参数等进行优化,可有效提高光刻分辨率、增大工艺窗口,此类技术即计算光刻技术(Computational Lithography),被认为是推动集成电路芯片按照摩尔定律继续发展的新动力。
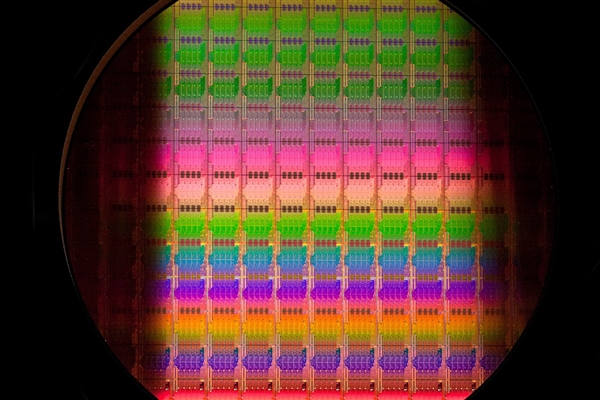
OPC 技术通过调整掩模图形的透过率分布修正光学邻近效应,从而提高成像质量。基于模型的 OPC 技术是实现 90nm 及以下技术节点集成电路制造的关键计算光刻技术之一。
上海光机所科研人员提出的这种基于虚拟边、双采样率像素化掩模图形的快速光学邻近效应修正技术,能够将不同类型的成像失真归结为两种类型的成像异常,即内缩异常与外扩异常。
利用不同的成像异常检测模板,依次在掩模图形的边缘和拐角等轮廓偏移判断位置进行局部成像异常检测,确定异常类型及异常区域的范围。
根据异常检测位置与异常区域范围,自适应产生虚拟边。通过移动虚拟边调整掩模的局部透过率分布,从而修正局部成像异常。借助修正策略和修正约束,实现高效的局部修正和全局轮廓保真度控制。
另外,双采样率像素化掩模充分利用了成像系统的衍射受限属性,在粗采样网格上进行成像计算与异常检测,在精采样网格上进行掩模修正,兼顾了成像计算效率与掩模修正分辨率。
利用多种掩模图形进行验证,仿真结果表明该 OPC 技术的修正效率优于常用的基于启发式算法的 OPC 技术。
相关研究成果已经发表在 Optics Express 上(论文链接)。
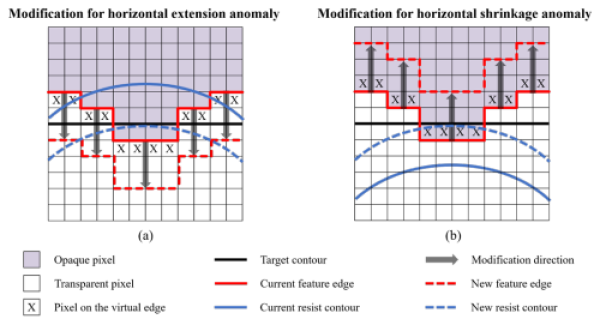
基于虚拟边的成像异常修正:(a)外扩异常修正,(b)内缩异常修正
来自: 驱动之家

